
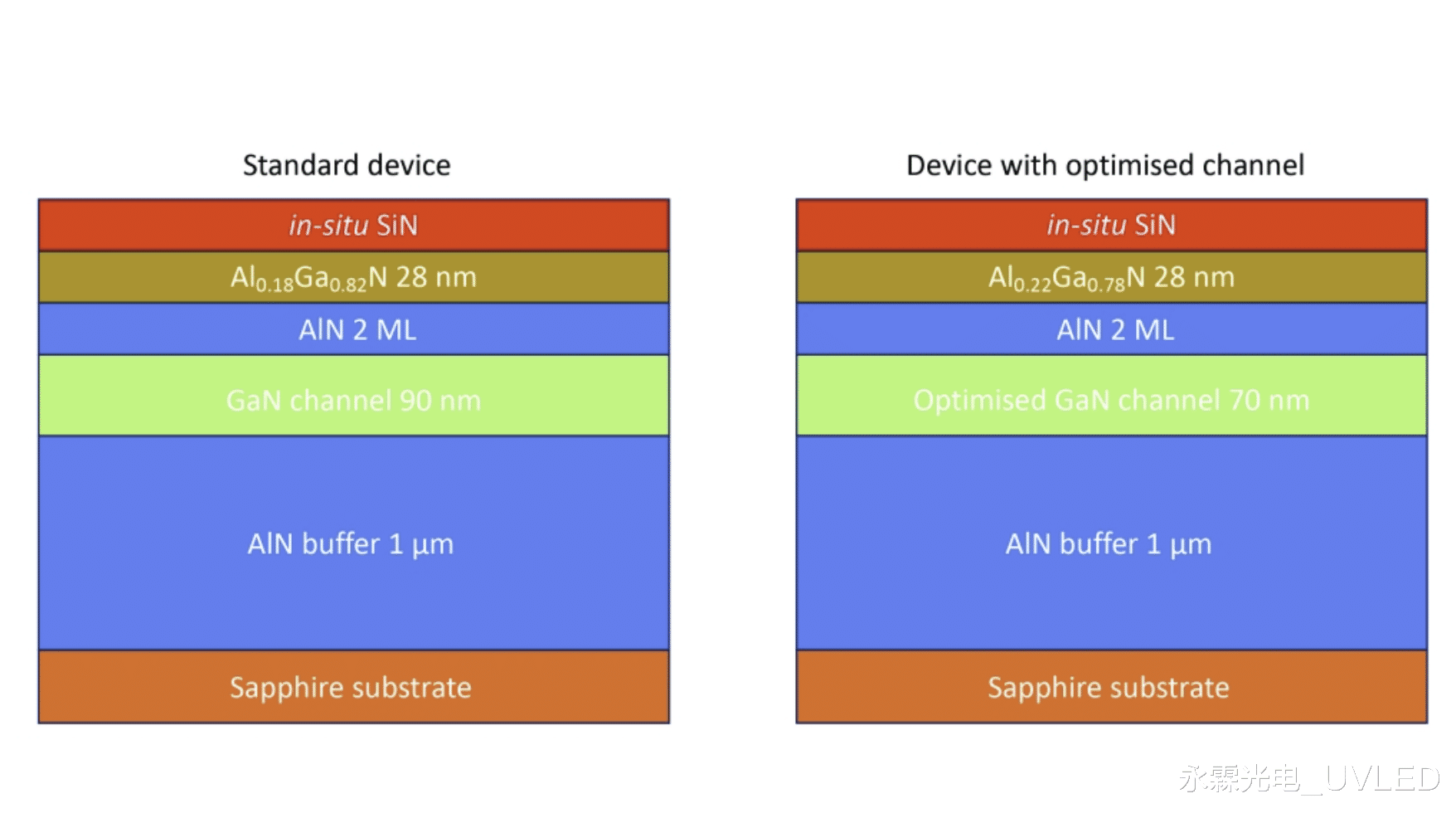
将沟道的生长进程细致地划分为十几层,能够显著提升MBE生长的GaN HEMT器件的阻断电压。一支来自中国的科研团队,通过成功制造出可阻断2.5 kV以上电压的简易器件,进一步增强了运用等离子体辅助MBE(分子束外延)技术制造GaN HEMT(高电子迁移率晶体管)的可行性。
尽管当前MOCVD(金属有机化学气相沉积)在功率电子用GaN HEMT的制造市场中占据主导地位,但等离子体辅助MBE这类外延技术具备一系列显著优势。该技术的一大突出优势在于,它能够生长出绝缘缓冲层,且无需进行掺杂。避免掺杂堪称一项极为显著的优点,因为这消除了GaN HEMT在导通与关断状态之间切换时出现的电流崩塌现象。等离子体辅助MBE的另一优势在于,在超高真空环境下进行生长能够有效抑制背景杂质和缺陷。
凭借这些优势,来自Massphoton、苏州晶能电子科技以及苏州纳米技术与纳米仿生研究所的研究团队,采用一种创新的生长方案,成功制造出具有70纳米厚沟道的GaN HEMT器件。为制造该器件,团队将沟道的生长过程细分为12层,并运用了镓液滴耗尽处理技术。据称,此方法通过减少缺陷态、降低孔隙缺陷密度,有效提升了GaN沟道的质量。
器件的制造过程起始于将一片3英寸、2°偏角的蓝宝石衬底置入等离子体辅助MBE腔室,于920°C的条件下沉积1000纳米厚的AlN缓冲层。随后,在815°C下依次生长70纳米厚的GaN沟道、2个单分子层的AlN以及28纳米厚的Al₀.₂₂Ga₀.₇₈N层。在完成这组III - N族材料叠层的生长后,团队原位(in - situ)添加了一层10纳米厚的SiN(氮化硅)钝化层。
此外,团队还制造了一个作为对照的器件,其沟道略厚(详情见图)。将这些外延晶圆加工成器件的过程如下:首先,通过低压CVD沉积一层30纳米厚的SiN层;接着,进行氮离子注入以实现台面隔离;然后,添加源极和漏极欧姆接触并进行退火。在生长了一层150纳米厚的SiN层后,定义了栅极窗口,刻蚀深度为120纳米,最终留下30纳米的SiN作为栅极绝缘层。随后沉积Ti/Al/Ti形成栅极金属和场板,最后添加互连层并沉积2微米厚的SiN顶层钝化层。
使用传输线法(TLM)进行的电学测量确定接触电阻为3.6 Ω·mm,晶圆的方块电阻为491 Ω/sq⁻¹。与此同时,霍尔测量给出了二维电子气密度为1.07 x 10¹³ cm⁻²,场效应迁移率为884 cm² V⁻¹ s⁻¹,这表明方块电阻为660 Ω/sq⁻¹。工程师们对不同测量方法得到的方块电阻数值差异归因于GaN沟道下方的缓冲层绝缘性不足,导致了寄生导电。
据称,改善缓冲层的生长条件将降低方块电阻,并允许使用更厚的沟道层。
对采用改良沟道生长的GaN HEMT进行的转移测量显示,输出特性中出现了电流饱和现象。这种特性在采用传统沟道的对照器件中并未观察到,这归功于分层生长带来的优异沟道质量。
优异沟道带来的额外好处还包括:开关比提高到了10⁷,以及在0.5 V的漏极偏压下,漏电流降低至1 nA mm⁻¹。在这两种情况下,相比传统沟道的HEMT器件,性能均有数量级的提升。
由于GaN沟道厚度较薄,这两种形式的HEMT器件都具有相对较高的导通电阻。
据该团队表示,增加沟道厚度将有助于降低导通电阻,此外通过引入渐变层和改进生长工艺,导通电阻也能进一步降低。
对照器件在1000 V时发生击穿,而具有优异沟道的HEMT器件可承受约2500 V的电压。该团队推测,这一远高于对照组的数值源于GaN沟道优异的绝缘特性。
永霖光电-UVSIS-UVLED紫外线应用专家-独家发布