(SEM)中二次电子(BSE)像和能量色散光谱(EDS)数据的信号原理、图像特点及解读方法SE像用于表征微观形貌,BSE像用于区分成分差异,EDS用于成分定性和半定量分析图1:电子束与样品作用激发各种信号。
二次电子(SE)像
SEM中最常用的成像信号,几乎所有材料的微观形貌表征都依赖它。要读懂二次电子图像,首先得理解其信号来源与形貌的关联逻辑。
信号原理
SEM的入射电子束(能量通常5-30—价电子获得能量后脱离原子束缚,从样品表面逸出,这些逸出的电子就是二次电子Electron,SE)。

1.:二次电子信号仅反映样品 “最表层” 的结构信息。
对形貌极敏感样品表面的凹凸起伏会直接影响二次电子的“逃逸效率”:
:入射电子束易与表层原子作用,二次电子能顺利逸出,探测器收集到的信号强,在图像中呈现亮区;
:二次电子逸出时会被周围结构遮挡,探测器收集到的信号弱,在图像中呈现暗区。

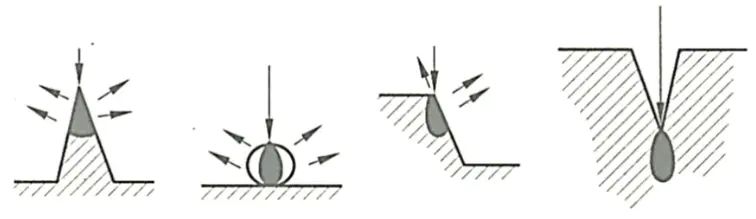
图4:形貌衬度原理。
这种“亮凸暗凹”的信号差异,正是二次电子图像能呈现三维立体形貌的核心原因。
数据解读
通过明暗分布还原表面拓扑结构:在低放大倍数下,观察样品的整体结构特征——例如金属粉末是否团聚、聚合物薄膜是否存在裂纹、陶瓷样品是否含有气孔。
微观尺寸测量SEM图像右下角通常标注,如“Scale bar=1 μm”),使用软件(如)测量关键尺寸——包括纳米颗粒的直径、纤维的直径与长度、孔洞的孔径等。
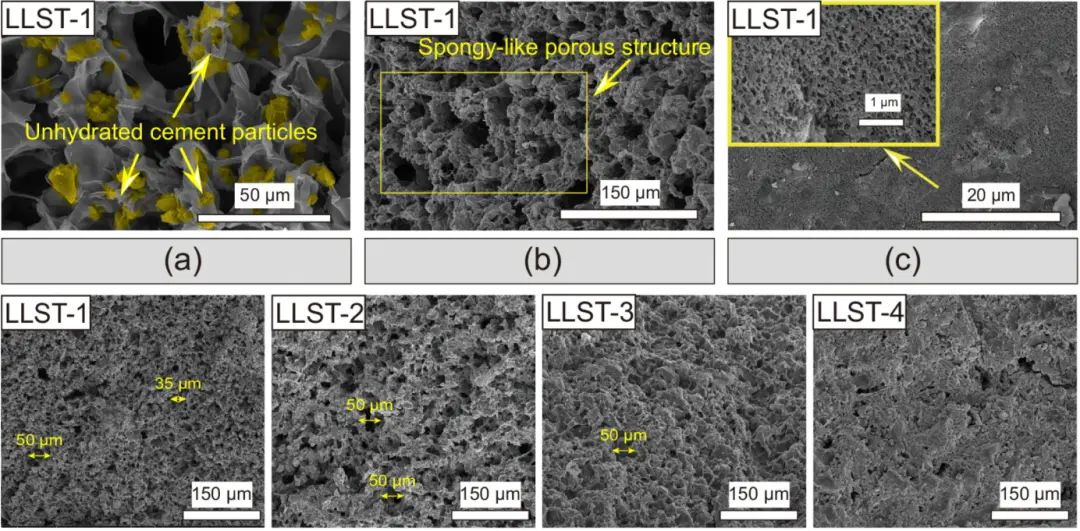
10.1038/s41467-025-58339-8二次电子图像能清晰呈现样品表面的微小缺陷,这些缺陷往往对材料性能至关重要:
:凹陷类缺陷如金属表面的腐蚀坑(暗点)、聚合物的应力裂纹(暗线),需结合实验背景分析成因图6:纳米晶镍受应力后表面裂缝的二次电子像。DO:。
背散射电子(BSE)像
BackElectron,BSE)的核心价值区分样品的成分差异入射电子束与样品作用时,一部分电子会与样品原子的原子核发生弹性碰撞——(BSE)。

背散射电子的强度与样品原子序数(——原子序数越大,原子核对入射电子的散射能力越强,背散射电子的产额越高,探测器收集到的信号越强。
(如金属(如聚合物中的(如纯此外,背散射电子的产生深度较深(几百纳米到几微米),能反映样品“近表层”的成分分布图8:二次电子像与背散射电子像的对比图。
数据解读
“通过明暗差异对应原子序数差异”1)成分分布
2)成分定性
若未知样品的成分,可通过背散射电子的明暗程度初步定性:
:通常为高原子序数元素(如金属中亮区Fe、Cu,Z=26-29);
:低原子序数元素(如注意:这是定性判断,不能直接确定元素种类(如亮区可能是图9:三种合金的背散射电子像。DOI:10.1038/s41586-025-09516-8。
EDS数据
Dispersive与配套使用的成分分析工具,能实现定性和半定量分析。
信号原理
,外层电子会跃迁到内层空位,跃迁过程中释放的能量以“特征X射线”图10:特征X射线激发示意图。
:根据特征–元素” 一一对应);
定量分析X射线的强度(峰面积)计算元素含量(强度越高,含量通常越高,需经校正)。
数据解读
能谱图和(包含元素符号、原子百分比、重量百分比)呈现:
核心骤:——例如在2.01keV处出现峰,对应Cu元素。
EDS的检测限通常为(重量百分比),低于此含量的元素可能无法检出(或峰强度过低,难以与背景区分),不能仅凭无峰判断元素不存在。
EDS定量分析结果通常以“原子百分比(At%)”呈现,需注意:定量结果是相对值,而非绝对值。EDS定量结果不能替代化学分析(如ICP-MS、元素分析C、O、N等轻元素的特征X射线能量低(),易被样品或探测器吸收,定量误差较大。

3:
“线扫描”和“面扫描”线扫描——例如分析金属涂层与基体的界面,线扫描曲线中涂层元素(如Cr)的强度从表面到基体逐渐降低,基体元素(如Fe)的强度逐渐升高,可直观确定涂层厚度。
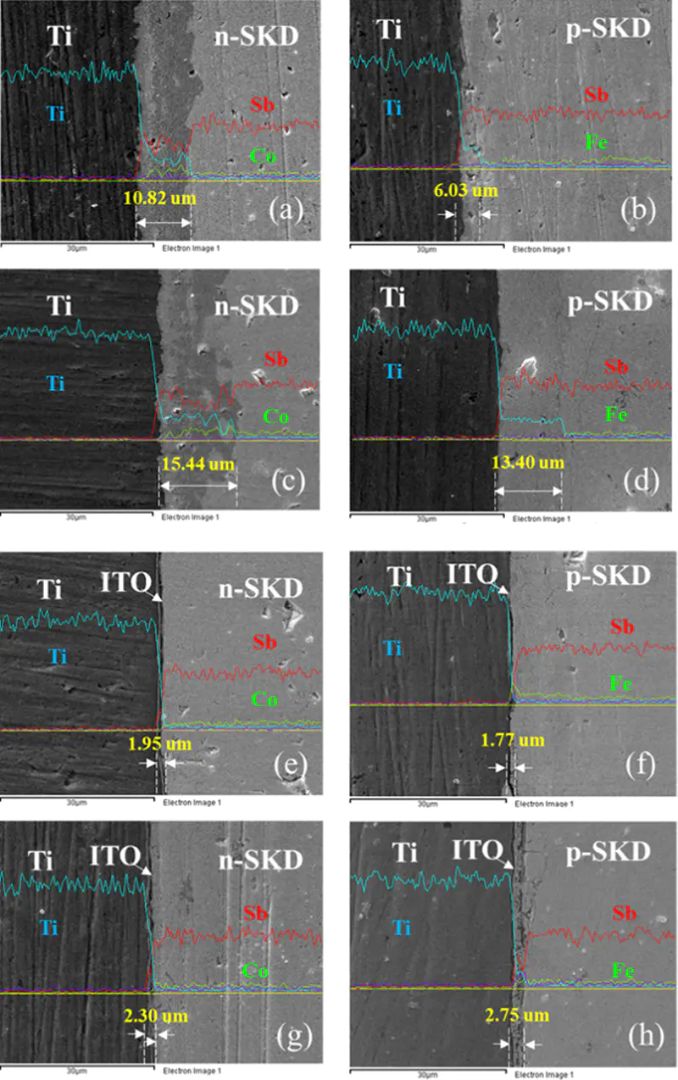
Ti/SKDTi/ITO/SKD面扫描:EDS信号,生成(不同颜色代表不同元素,颜色深浅代表含量高低)图13:三金属Fe-Co-Ni MOF的FE-SEM-EDS元素分布图。DOI:10.1021/jacs.1c10963。